Модель Форухи — Блумер
Модель Форухи — Блумер — дисперсионные уравнения для среды с поглощением выведенные А. Р. Форухи и И. Блумер для комплексного показателя преломления n +ik, которые были опубликованы в 1986[1] и 1988 годах[2]. Публикация 1986 г. относится к аморфным материалам, а публикация 1988 г. — к кристаллическим. Впоследствии, в 1991 году, их работа была включена в качестве главы в «Справочник оптических констант». Дисперсионные уравнения Форухи — Блумер описывают, как фотоны различной энергии взаимодействуют с тонкими плёнками. При использовании в спектроскопической рефлектометрии дисперсионные уравнения Форухи — Блумер позволяют определять n (коэффициент преломления) и k (коэффициент поглощения) для аморфных и кристаллических материалов как функции энергии фотона E. Значения n(E) и k(E) называются спектрами n и k, которые также могут выражаться в зависимости от длины волны света λ, поскольку E = hc/λ, где h - постоянная Планка, а c — скорость света в вакууме. Вместе n и k часто называют «оптическими константами» материала (хотя они не являются константами, поскольку их значения зависят от энергии фотонов).
Уравнения[править | править код]
Вывод дисперсионных уравнений Форухи — Блумер основан на получении выражения для k как функции энергии фотона, символически записанного как k(E), исходя из первых принципов квантовой механики и физики твёрдого тела. Выражение для n как функции энергии фотона, символически записанное как n(E), затем определяется из выражения для k (E) в соответствии с соотношениями Крамерса — Кронига[3], которых гласят, что n(E) — это преобразование Гильберта k(E).
Аморфные материалы[править | править код]
Дисперсионные уравнения Форухи — Блумер для n(E) и k(E) для аморфных материалов имеют вид:
Каждый из пяти параметров A, B, C, Eg и n(∞) имеет физическое значение[1]. Eg — ширина запрещённой зоны материала в оптическом диапазоне. A, B и C зависят от зонной структуры материала. Это положительные константы, такие что 4C-B2>0. Наконец, n(∞) — константа больше единицы, представляет собой значение n при E = ∞. Параметры B0 и C0 в уравнении для n (E) не являются независимыми параметрами, но зависят от основных параметров модели A, B, C и Eg. Они задаются формулами:
где
Таким образом, для аморфных материалов нужно задать пять параметров, чтобы полностью описать зависимость как n, так и k от энергии фотона E.
Кристаллические материалы[править | править код]
Для кристаллических материалов, которые имеют несколько пиков в спектрах n и k, дисперсионные уравнения Форухи — Блумер обобщаются следующим образом:
Количество членов в каждой сумме q равно количеству пиков в n- и k- спектрах материала. Каждый член в сумме имеет свои собственные значения параметров Ai, Bi, Ci, Egi, а также свои собственные значения B0i и C0i. Подобно аморфному случаю, все параметры имеют физическое значение[2].
Характеризация тонких плёнок[править | править код]
Показатель преломления (n) и коэффициент поглощения (k) связаны с взаимодействием между материалом и падающим светом и относятся к преломлению и поглощению света в материале, соответственно. Их можно рассматривать как «отпечатки пальцев» для материала. Покрытия из тонкоплёночного материала на различных подложках обеспечивают важные применения для индустрии микротехнологий, и n, k, а также толщина t этих тонкоплёночных составляющих должны измеряться и контролироваться для обеспечения воспроизводимости технологических процессов.
Изначально ожидалось, что дисперсионные уравнения Форухи — Блумер для n и k будут применяться к полупроводникам и диэлектрикам, будь то в аморфном, поликристаллическом или кристаллическом состояниях. Однако было показано, что они также описывают n- и k- спектры прозрачных проводников[4], а также металлических соединений[5][6][7][8][9][10][11][12][13][14]. Было обнаружено, что этот формализм для кристаллических материалов применим также к полимерам[15][16][17], которые состоят из длинных цепочек молекул, не образующих кристаллографическую структуру в классическом смысле.
В литературе можно найти другие модели дисперсии, которые можно использовать для получения n и k, такие как Тауц — Лоренца[18][19]. Две хорошо известные модели: Коши и Зелмейера предоставляют эмпирические выражения для n, действительные в ограниченном диапазоне частот, и полезны только для плёнок со слабым поглозщением, где k = 0. Следовательно, модель Форухи — Блумер используется для измерения тонких плёнок в различных приложениях[4][5][6][7][8][9][10][11][12][13][14][15][16][17].
В следующих обсуждениях все переменные энергии фотонов E будут описаны в терминах длины волны света λ, поскольку экспериментальные переменные, связанные с тонкими плёнками, обычно измеряются по спектру длин волн. Спектры n и k тонкой плёнки нельзя измерить напрямую, их следует определять косвенно, исходя из измеряемых величин, которые зависят от них. Спектроскопическая отражательная способность, R(λ), является одной из таких измеряемых величин. Другая величина — спектроскопический коэффициент пропускания T (λ), применяется, когда подложка на которой расположена плёнка прозрачна. Спектроскопический коэффициент отражения тонкой плёнки на подложке представляет собой отношение интенсивности света, отражённого от образца, к интенсивности падающего света, измеренного в каком-то диапазоне длин волн, тогда как спектроскопический коэффициент пропускания, T (λ), представляет собой отношение интенсивности света, прошедшего через образец, к интенсивности падающего света, измеренного в каком-то диапазоне длин волн; как правило, будет наблюдаться также отражённый сигнал R(λ), сопровождающий T(λ).
Измеримые величины R(λ) и T(λ) зависят не только от n(λ) и k(λ) плёнки, но также от толщины плёнки t, а также от n(λ) и k(λ) подложки. Для кремниевой подложки значения n(λ) и k(λ) известны и принимаются в качестве заданных входных данных. Задача определения характеристик тонких плёнок включает извлечение t, n(λ) и k(λ) плёнки из измерения R(λ) и/или T(λ). Этого можно достичь, комбинируя дисперсионные уравнения Форухи — Блумер для n(λ) и k(λ) с уравнениями Френеля для отражения и пропускания света на границе раздела[20], чтобы получить теоретические, физически обоснованные выражения для коэффициента отражения и коэффициент пропускания. При этом задача сводится к получению пяти параметров A, B, C, Eg и n(∞), которые содержат n(λ) и k(λ), наряду с толщиной плёнки, t, за счёт использования нелинейного регрессионного анализ методом наименьших квадратов[21][22]. Процедура подгонки влечёт за собой итеративное улучшение значений A, B, C, Eg, n(∞), t, чтобы уменьшить сумму квадратов ошибок между модельными R(λ) и T(λ) и измеренными спектрами R(λ) и T(λ).
Помимо спектрального коэффициента отражения и пропускания, спектроскопическая эллипсометрия также может использоваться аналогичным образом для характеризации тонких плеёнок и определения t, n(λ) и k(λ).
Примеры измерений[править | править код]
Следующие ниже примеры показывают универсальность использования дисперсионных уравнений Форухи — Блумер для характеристики тонких плёнок с использованием инструмента, основанного на спектроскопической отражательной способности, близкой к нормальному падению. Спектроскопическое пропускание, близкое к нормальному, также используется, когда подложка прозрачна. Спектры n(λ) и k(λ) каждой плёнки получают вместе с толщиной плёнки в широком диапазоне длин волн от глубокого ультрафиолетового до ближнего инфракрасного (190—1000 нм).
В следующих примерах обозначения теоретической и измеренной отражательной способностей на спектральных графиках выражаются как «R-theor» и «R-Meas», соответственно.
Ниже приведены схемы, изображающие процесс измерения тонких плёнок:
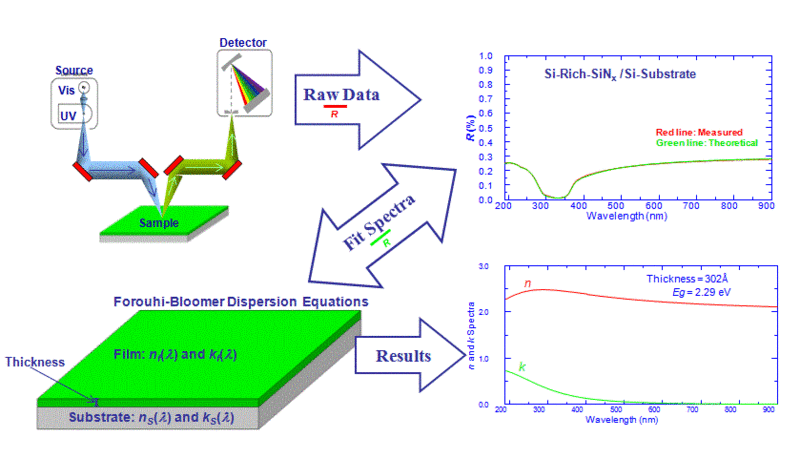
Уравнения дисперсии Форухи — Блумер в сочетании со Строгим методом связанных волн (RCWA) также использовались для получения подробной информации о профиле (глубина, CD, угол боковой стенки) траншейных поверхностных структур. Для извлечения структурной информации данные поляризованного широкополосного отражения, Rs и Rp, должны быть измерены в большом диапазоне длин волн из периодической структуры (решётки), а затем проанализированы с помощью модели, которая включает дисперсионные уравнения Форухи — Блумер и RCWA. Входные данные для модель включают шаг решётки и n- и k- спектры всех материалов в структуре, в то время как выходные данные могут включать глубину, CD в нескольких местах и даже угол боковой стенки. Спектры n и k таких материалов могут быть получены в соответствии с методологией, описанной в этом разделе для измерений тонких плёнок.
Ниже приведены схемы, изображающие процесс измерения траншейных поверхностных структур. Далее следуют примеры измерения траншеи.

В рисунке 1 показан один широкий максимум в спектрах n(λ) и k(λ) плёнки a-Si, как и ожидалось для аморфных материалов. По мере перехода материала к кристалличности широкий максимум сменяется несколькими более резкими пиками в его спектрах n(λ) и k(λ), как показано на графиках.
Когда измерение включает две или более плёнки в стопке плёнок, теоретическое выражение для коэффициента отражения должно быть расширено, чтобы включить спектры n(λ) и k(λ) плюс толщину t каждой плёнки. Однако регрессия может не сходиться к уникальным значениям параметров из-за нелинейного характера выражения для отражательной способности. Так что полезно исключить некоторые из неизвестных. Например, спектры n(λ) и k(λ) одной или нескольких плёнок могут быть известны из литературы или предыдущих измерений и удерживаться фиксированными (не могут изменяться) во время регрессии. Для получения результатов, показанных на рисунке 1, спектры n(λ) и k(λ) слоя SiO2 были фиксированы, а другие параметры, n(λ) и k(λ) a-Si, плюс толщина как a-Si, так и SiO2 можно было изменять.
Примечания[править | править код]
- ↑ 1 2 Forouhi, A.R. (1986). "Optical Dispersion Relations for Amorphous Semiconductors and Amorphous Dielectrics". Physical Review B. 34 (10): 7018—7026. Bibcode:1986PhRvB..34.7018F. doi:10.1103/physrevb.34.7018. PMID 9939354.
- ↑ 1 2 Forouhi, A.R. (1988). "Optical Properties of Crystalline Semiconductors and Dielectrics". Physical Review B. 38 (3): 1865—1874. Bibcode:1988PhRvB..38.1865F. doi:10.1103/physrevb.38.1865.
- ↑ Roman, P. Advanced Quantum Theory. — Addison-Wesley, 1965.
- ↑ 1 2 Torkaman, N.M. (2010). "Crystallographic Parameters and Electro-Optical Constants in ITO Thin Films". Materials Characterization. 61 (3): 362—370. doi:10.1016/j.matchar.2009.12.020.
- ↑ 1 2 Lakhdar, M.H. (2014). "Thickness Effect on the Structural and Optical Constants of Stibnite Thin Films Prepared by Sulfidation Annealing of Antimony Films". Optik – International Journal for Light and Electron Optics.
- ↑ 1 2 Al-Khanbashi, H.A. (2014). "Spectroscopic Ellipsometry of Zn1−xCuxO Thin Films Based on a Modified Sol–Gel Dip-Coating Technique". Spectrochimica Acta Part A: Molecular and Biomolecular Spectroscopy. 118: 800—805. Bibcode:2014AcSpA.118..800A. doi:10.1016/j.saa.2013.09.085. PMID 24157332.
- ↑ 1 2 Nakamura, T. (2014). "Emission Decay Rate of a Light Emitter on Thin Metal Films". Japanese Journal of Applied Physics. 53 (4). Bibcode:2014JaJAP..53d5201N. doi:10.7567/jjap.53.045201.
- ↑ 1 2 Winkler, M.T. (2014). "Optical Designs that Improve the Efficiency of Cu2ZnSn(S,Se)4 Solar Cells". Energy & Environmental Science. 7 (3): 1029—1036. doi:10.1039/c3ee42541j.
- ↑ 1 2 Miao, L. (2013). "Cost-Effective Nanoporous SiO2–TiO2 Coatings on Glass Substrates with Antireflective and Self-Cleaning Properties". Applied Energy. 112: 1198—1205. doi:10.1016/j.apenergy.2013.03.043.
- ↑ 1 2 Zhang, F. (2013). "Temperature-Dependent Optical Properties of Titanium Oxide Thin Films Studied by Spectroscopic Ellipsometry". Applied Physics Express. 6 (12). Bibcode:2013APExp...6l1101Z. doi:10.7567/apex.6.121101.
- ↑ 1 2 Sheng-Hong, Y. (2013). "Optical Study of Sol-gel Processed Nd-doped BiFeO3 Multiferroic Films by Spectroscopic Ellipsometry". Ferroelectrics. 454 (1): 78—83. doi:10.1080/00150193.2013.842802.
- ↑ 1 2 Balakrishnan, G. (2011). "A Study of Microstructural and Optical Properties of Nanocrystalline Ceria Thin Films Prepared by Pulsed Laser Deposition". Thin Solid Films. 519 (8): 2520—2526. Bibcode:2011TSF...519.2520B. doi:10.1016/j.tsf.2010.12.013.
- ↑ 1 2 Cheng, K.W. (2010). "Effect of Sb on the growth and photoelectrochemical response of AgIn5S8 Film Electrodes Created by Solution Growth Technique". Chemical Engineering Science. 65 (1): 74—79. doi:10.1016/j.ces.2009.02.002.
- ↑ 1 2 Das, N.S. (2010). "Effect of Film Thickness on the Energy Band Gap of Nanocrystalline CdS Thin Films Analyzed by Spectroscopic Ellipsometry". Physica E: Low-dimensional Systems and Nanostructures. 42 (8): 2097—2102. Bibcode:2010PhyE...42.2097D. doi:10.1016/j.physe.2010.03.035.
- ↑ 1 2 Xiong, K. (2014). "Phosphor-Doping Enhanced Efficiency in Bilayer Organic Solar Cells due to Longer Exciton Diffusion Length". Journal of Luminescence. 151: 193—196. Bibcode:2014JLum..151..193X. doi:10.1016/j.jlumin.2014.02.016.
- ↑ 1 2 Huynh, T.P. (2013). "Electrochemically Synthesized Molecularly Imprinted Polymer of Thiophene Derivatives for Flow-Injection Analysis Determination of Adenosine-5′-Triphosphate (ATP)". Biosensors and Bioelectronics. 41: 634—641. doi:10.1016/j.bios.2012.09.038. PMID 23131778.
- ↑ 1 2 Zhu, D. (2008). "Determination of the Optical Constants of Polymer Light-Emitting Diode Films from Single Reflection Measurements". Journal of Physics D: Applied Physics. 41 (23). Bibcode:2008JPhD...41w5104Z. doi:10.1088/0022-3727/41/23/235104.
- ↑ Laidani, N. (2008). "Optical Absorption Parameters of Amorphous Carbon Films from Forouhi–Bloomer and Tauc–Lorentz Models: A Comparative Study". Journal of Physics: Condensed Matter. 20 (1). Bibcode:2008JPCM...20a5216L. doi:10.1088/0953-8984/20/01/015216.
- ↑ Easwarakhanthan, T. (2007). "Forouhi–Bloomer and Tauc–Lorentz Optical Dispersions Applied Using Spectroscopic Ellipsometry to Plasma-Deposited Fluorocarbon Films". Journal of Applied Physics. 101 (7): 073102–073102–7. Bibcode:2007JAP...101g3102E. doi:10.1063/1.2719271.
- ↑ Heavens, O.S. Optical Properties of Thin Solid Films. — New York : Dover, 1965.
- ↑ Levenberg, K. (1944). "A Method for the Solution of Certain Non-Linear Problems in Least Squares". The Quarterly of Applied Mathematics. 2 (2). doi:10.1090/qam/10666.
- ↑ Marquardt, D.W. (1963). "An Algorithm for Least-Squares Estimation of Nonlinear Parameters". Journal of the Society for Industrial and Applied Mathematics. 11 (2): 431—441. doi:10.1137/0111030.



![{\displaystyle C_{0}={\frac {A}{Q}}\ \left[({E_{g}}^{2}+C){\frac {B}{2}}\ -2E_{g}C\right]\,,}](https://wikimedia.org/api/rest_v1/media/math/render/svg/640f3a99a0f07307d2911ed6b94d52c6f7e4ba60)

![{\displaystyle k(E)=\sum _{i=1}^{q}\left[{\frac {A_{i}(E-E_{g_{i}})^{2}}{E^{2}-B_{i}E+C_{i}}}\right]\,,}](https://wikimedia.org/api/rest_v1/media/math/render/svg/10ae17877160a21910022238cd3904592f74c3a8)
![{\displaystyle n(E)=n(\infty )+\sum _{i=1}^{q}\left[{\frac {B_{0_{i}}E+C_{0_{i}}}{E^{2}-B_{i}E+C_{i}}}\right]\,.}](https://wikimedia.org/api/rest_v1/media/math/render/svg/2366744e85617a14824f926f05e99d68e9de4577)

